原子層沉積設備
加熱式原子層沉積為一種氣相化學沉積技術。大多數的ALD反應,將使用兩種化學物質稱為前驅物。這些前驅物以連續且自限的方式與材料表面進行反應。通過ALD循環的次數,緩慢的沉積薄膜。而熱沉積式的ALD需要較高的製程溫度(傳統為150~350 oC)。
原子層沉積系統
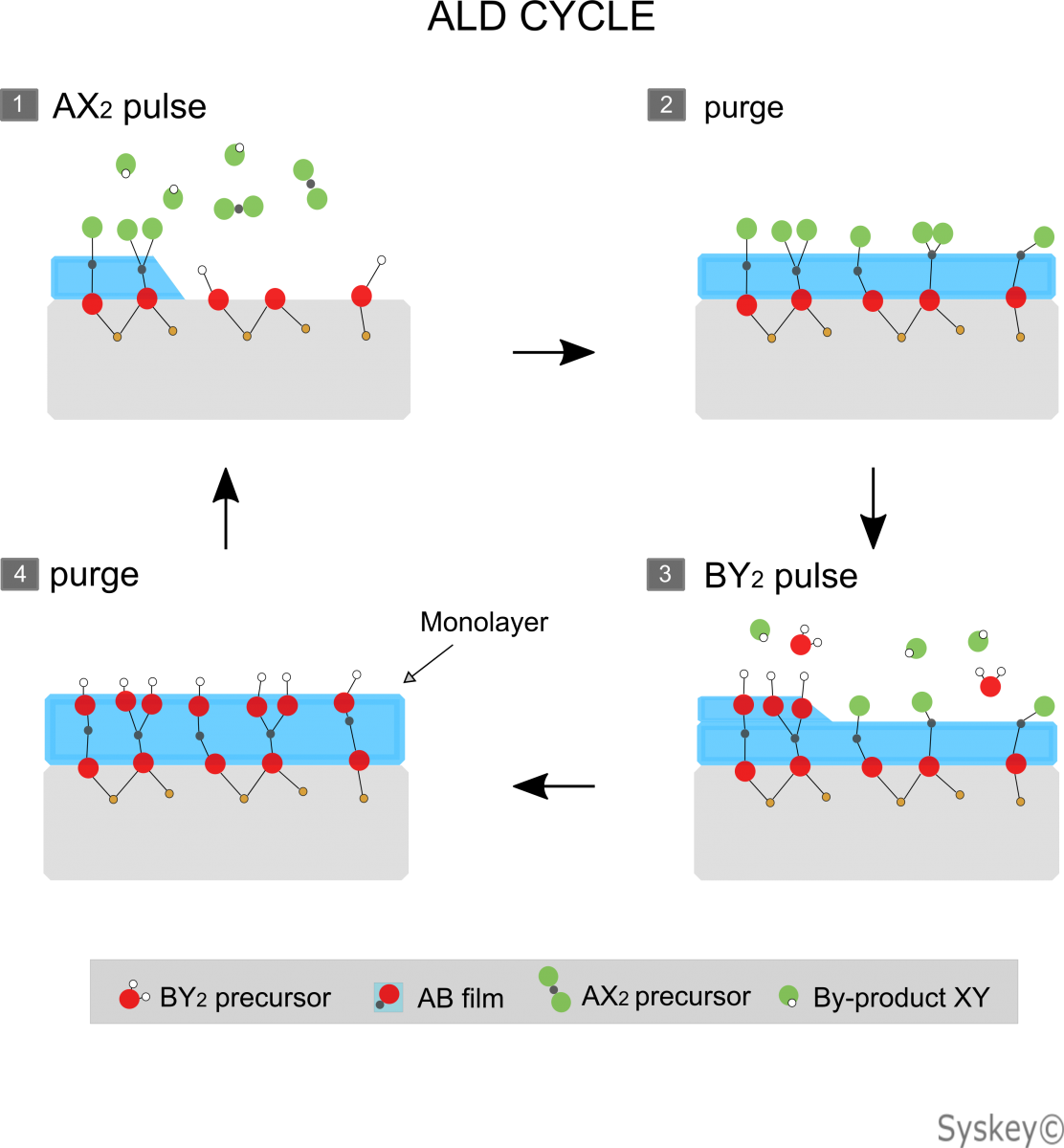
ALD 用於薄膜沉積的原子層沉積是基於順序使用氣相化學過程的最重要技術之一;它可以被視為一種特殊類型的化學氣相沉積(CVD)。多數ALD反應使用兩種或更多種化學物質(稱為前驅物,也稱為“反應物”)。這些前驅物以一種連續的且自我限制的方式,一次與一種材料的表面反應。通過多個ALD循環,薄膜被緩慢沉積。 ALD為製造半導體元件的重要製程,並且是可用於合成納米材料主要工具的一部分。
ALD具有許多優點,例如出色的均勻性,在複雜形狀的基板表面上沉積的具有相同膜厚的膜保形性,低溫處理。因此,ALD被應用於微電子,納米技術和生物技術領域中,這些領域經常在有機和生物樣品之類的軟基底上工作。
厚度均匀度(WIW):
單個12英寸晶圓用於沉積目標厚度為5nm的Al2O3和HfO2膜。使用橢偏儀進行27點厚度測量並輸入標準偏差公式。在±0.5nm範圍內和均勻度的5%以內。
| Al2O3 均匀度=1.58% |
HlfO2 均匀度=1.27% |
.png) |
.png) |
介電常數和功函數:
準備三個矽晶片,並以固定的厚度沉積Al2O3 / TiN和化學氧化物/ HfO2 / TiN。測量三個樣品的CV圖以計算介電常數和洩漏電流:介電常數應為7〜9(Al2O3)和18〜22(HfO2),並且洩漏電流小於1 nA(@ 1V)。